发布时间:2020-09-09 09:50:17 责任编辑:http://www.hanstars.cn/阅读:234
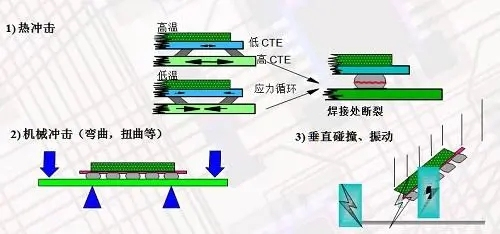
随着手机、电脑等便携式电子产品的发展趋向薄型化、小型化、高性能化,IC封装也趋向小型化、高聚集化方向发展。而底部封装点胶工艺可以解决精密电子元件的很多问题,比如BGA、芯片不稳定,质量不老牢固等,这也是underfill底部填充工艺受到广泛应用的原因之一。
BGA和CSP是通过锡球固定在线路板上,存在热应力、机械应力等应力集中现象,如果受到冲击、弯折等外力作用,焊接部位容易发生断裂。此外,如果上锡太多以至于锡爬到元件本体,可能导致引脚不能承受热应力和机械应力的影响。因此芯片耐机械冲击和热冲击性比较差,出现产品易碎、质量不过关等问题。
针对以上问题,汉思化学经过研究设计了针对性用胶解决方案:
高精度的电子芯片,每一个元件都极其微细且关键,为了稳定BGA,需要多一个底部封装步骤。
进行underfill底部填充胶的芯片在跌落测试和高低温测试中有优异的表现,所以在焊球直径小、细间距焊点的BGA、CSP芯片组装中,都要使用底部填充胶进行底部补强。
作为全球领先的化学材料服务商,汉思化学一直致力于发展芯片级底部填充胶的高端定制服务,可针对更高工艺要求和多种应用场景的芯片系统,提供相对应的BGA芯片底部填充胶与元器件底部填充胶,有效保障芯片系统的高稳定性和高可靠性,延长其使用寿命,为芯片提供更加稳定的性能和更可靠的品质.
为针对不同应用领域工艺要求,进行产品开发拓展,汉思化学独立研发团队联合复旦大学、常州大学等多个名校科研单位开展先进胶粘剂技术解决方案研究。 针对芯片BGA和CSP提出的更高填充要求,汉思化学不断加大研发力度,并持续寻求更多突破,其底部填充胶在国内同行中占据绝对工艺优势。
汉思化学芯片级底部填充胶采用国际先进配方技术及进口原材料,真正帮助客户实现产品的稳定性和可靠性。产品通过SGS认证,获得RoHS/HF/REACH/7P检测报告,整体环保标准比行业高出50%。目前,该系列产品不但成功进入华为、韩国三星、VIVO、OPPO、小米集团、德赛集团、上汽集团、中国电子科技集团、北方微电子等多家著名品牌供应链体系,并凭借出色的品质,极高的性价比,受合作方的一致认可。
请填写您的需求,我们将尽快联系您