发布时间:2019-06-12 15:46:36 责任编辑:www.hanstars.cn阅读:406
中美贸易战蔓延至科技行业,把华为频频推上热搜。近期,华为创始人任正非接受央视采访,透露了几项华为掌握的核心黑科技,其中一项黑科技竟是“胶水”!华为究竟掌握了怎样的“胶水”黑科技,竟然助力华为手机完胜苹果手机呢?

任正非:“比如说我们和苹果手机差距是什么?说苹果在寒冷地带就照不了相,我们在寒冷地带能照相。”
任正非:“这是胶水,这是我们科学家发明的一种胶水,这个胶水在低温下不凝固。我们在低温下就可以照相,因为镜头是用胶水粘起来的。”
在专访中,任正非以颇为自豪的语气跟主持人介绍,说:“我们和苹果手机差距是什么?苹果在寒冷地带就照不了相,我们在寒冷地带能照相。这是我们科学家发明的一种胶水,这个胶水在低温下不凝固,因为镜头是用胶水粘起来的,所以我们在低温下就可以照相。其实这都是基础科学带来的,突破这个基础科学是需要非常长的时间积累。”
华为手机对低温环境适用性很强,华为Mate20 系列在零下20多度的正常使用完全不受影响。华为官方还专门做了一个实验,将手机直接冻在冰里面几个小时,然后拿出来依然能够使用,显示出了强悍的抗低温性能,而起到这一关键作用的就是任正非介绍中所说的“胶水”黑科技。

事实上,电子胶粘剂一直以来都在电子电器、汽车、轨道交通、航天航空、军工等工业制造领域发挥意想不到的惊人作用和举足轻重的价值。就智能手机而言,其主要胶水应用主要要以下几种:
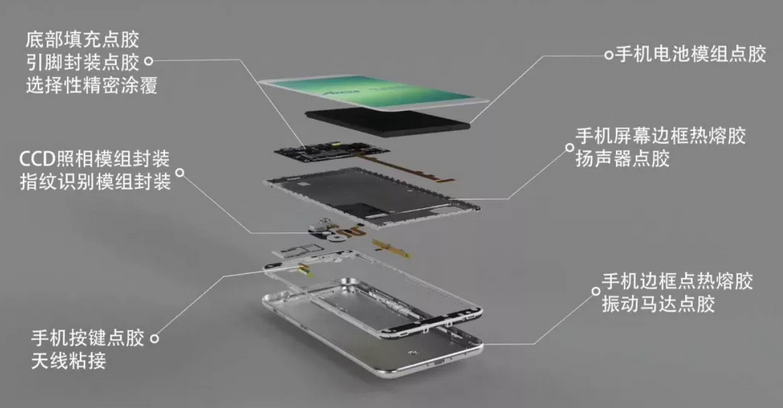
1.CCD照像模组封装:摄像头模组主要包括以下几部分:FPC、SENSOR、LENS、VCM等,其内部结构复杂精密,多处元件都需要通过点胶组装。
2. 指纹识别模组封装/underfill点胶: FPC的折弯、贴合,Touch ID 芯片 underfill点胶,FPC元器件的包封点胶,金属框点胶粘接,蓝宝石点胶粘接。
3.手机边框点热熔胶:通针针对近几年来兴起的触屏行业,包括手机平板在内的触摸屏点热熔胶固定。
4.半导体点银胶:通过调整阀的参数可以实现点银胶尖头和圆头模式。
5.LED晶源封装:LED灯珠点胶,由过去接触式点胶升级为非接触式点胶,效率更快、品质更好。
6.SMT点红胶:应对双面回流焊接,波峰焊工艺,或者零件加固,0402元件红胶工艺。
7.FPC软板封装:针对FPC上的元器件,在焊接之外提供与基板之间的强度提升,应对电子产品封装小型化的趋势。
8.IC边缘封装:非接触点胶,晶片加固,增加晶片的抗震能力,降低跌落等冲击对焊点的损害。
其中,手机芯片底部填充胶underfill至关重要,多采用全自动点胶机bga底部填充胶工艺,底部填充胶的应用原理是利用毛细作用使得胶水迅速流过BGA芯片底部,其毛细流动的最小空间是10um。
作为华为等多家著名消费电子厂商的指定供应商之一,汉思化学为其提供了相对应的芯片底部填充胶与元器件底部填充胶,其自主研制的底部填充胶品质媲美国际先进水平,具有粘接强度高,适用材料广,黏度低、固化快、流动性高、返修性能佳等诸多优点,不仅清洁高效,而且质量非常稳定,被广泛应用于手机蓝牙芯片、摄像模组芯片、手机电池保护板等生产环节上,有效起到加固、防跌落等作用。
请填写您的需求,我们将尽快联系您