发布时间:2023-02-08 11:30:48 责任编辑:www.hanstars.cn阅读:200
汉思新材料芯片封装胶underfill底部填充胶点胶工艺基本操作流程

一、烘烤
烘烤,主要是为了确保主板的干燥。实施底部填充胶之前,如果主板不干燥,容易在容易在填充后有小气泡产生,在最后的固化环节,气泡就会发生爆炸,从而影响焊盘与PCB之间的粘结性,也有可能导致焊锡球与焊盘的脱落。在烘烤工艺中,参数制定的依据PCBA重量的变化,具体可以咨询汉思新材料。
二、预热
对主板进行预热,可以提高Underfill底部填充胶的流动性。要注意的是——反复的加热势必会使得PCBA质量受到些许影响,所以建议这个环节建议温度不宜过高,建议预热温度:40~60℃。
三、点胶
底部填充胶填充点胶,通常实施方法有操作人员的手动填充和机器的自动填充,无论是手动和自动,一定需要借助于胶水喷涂控制器,其两大参数为喷涂气压和喷涂时间设定。不同产品不同PCBA布局,参数有所不同。
由于底部填充胶的流动性,填充的两个原则:
1. 尽量避免不需要填充的元件被填充 ;
2.绝对禁止填充物对扣屏蔽罩有影响。依据这两个原则可以确定喷涂位置。
在底部填充胶用于量产之前,需要对填充环节的效果进行切割研磨试验,也就是所谓的破坏性试验,检查内部填充效果。通常满足两个标准:
1.跌落试验结果合格;
2.满足企业质量要求。
底部填充胶因毛细管虹吸作用按箭头方向自动填充。通常情况下常用“一”型和“L”型,和“U”型作业,通过表面观察,可以看到会形成底部填充初步效果。
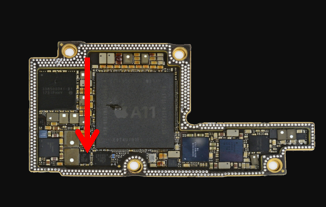
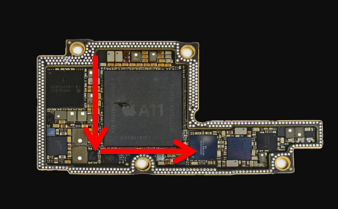

四、固化
底部填充胶固化,需要再经过高温烘烤以加速环氧树脂的固化时间,固化条件需要根据填充物的特性来选取合适的底部填充胶产品。
不同型号的底部填充胶固化条件不相同,根据实际参数而定。
底部填充胶是一种单组份环氧密封、低卤素底部填充胶。常用于手机、平板电脑、数码相机等电子产品CSP、BGA,指纹模组、摄像头模组、手机电池部件组装等需要底部制程保护的填充。可形成一致和无缺陷的底部填充层,可有效降低由于硅芯片与基板间的总体温度膨胀和不匹配或外力造成的冲击。
汉思新材料在芯片胶、芯片封装胶、底部填充胶、环氧胶水的研发上深耕10多年,产品配方成熟,性能稳定,有自己的研发团队和生产工厂,在业内有着良好的口碑,产品线全,适合客户不同产品和工艺要求,技术储备雄厚,可根据客户具体需求进行定制调整。

汉思化学芯片封装胶underfill底部填充胶的应用优势,耐候性好,化学性能优异,可返修性能优异,减少不良率、符合国际环保无铅要求,并通过权威部门检测,产品低黏度,流动快,均匀无空洞填充层,粘接强度高,高可靠性,耐热和机械冲击,固化时间短,可大批量生产,可以替代国外知名品牌。已经广泛应用在人工智能、5G技术、广域物联网、局域物联网、消费类电子、汽车电子、LED控制板、无人机、医疗产业、军工电子、新能源等高科技领域。

请填写您的需求,我们将尽快联系您